
研究原子層沉積 (ALD) 生長的薄膜的保形性不僅從應用角度來看很有趣。它還可以提供有價值的基本信息,如有關反應概率的信息。研究薄膜保形性也被證明是提升等離子體 ALD 一種有效的方法。本篇文章內容來自K. Arts, W.M.M. Kessels 和 H.C.M Knoops 的研究,為大家深度揭秘與優化 ALD 薄膜生長的保形性。
通過表面吸附和表面復合而損失的反應物分子看起來可能相似,但會導致非常不同的生長行為。本篇文章將從三個方面解釋這一現象,并希望通過具象的案例圖片和動畫演示來幫助大家理解反應、擴散和復合限制生長等概念以及在(等離子) ALD 過程中優化薄膜保形性。
01.模擬 ALD 保形性:擴散、吸附和復合
要將 ALD 過程中的薄膜保形性與反應概率等基本參數聯系起來,我們需要一個數值或分析模型來描述生長過程。Cremers 等人最近在研究中已經報道了幾種這樣的模型,其中許多模型受到 Gordon 在 2003 年提出的分析模型的啟發。
該模型可以充分預測在擴散限制生長的情況下保形涂覆高縱橫比 (高 AR) 孔所需的最小反應物劑量(下一節將解釋),無需深入研究已報告模型的細節。值得一提的是,這些模型本質上都是模擬一個 ALD 半周期內獲得的表面覆蓋率θ。從實驗上講,這種表面覆蓋率或“可用吸附位點的反應分數"可以與每周期生長率 (GPC) 相關聯,因此與沉積膜的厚度有關,如圖 1 所示。
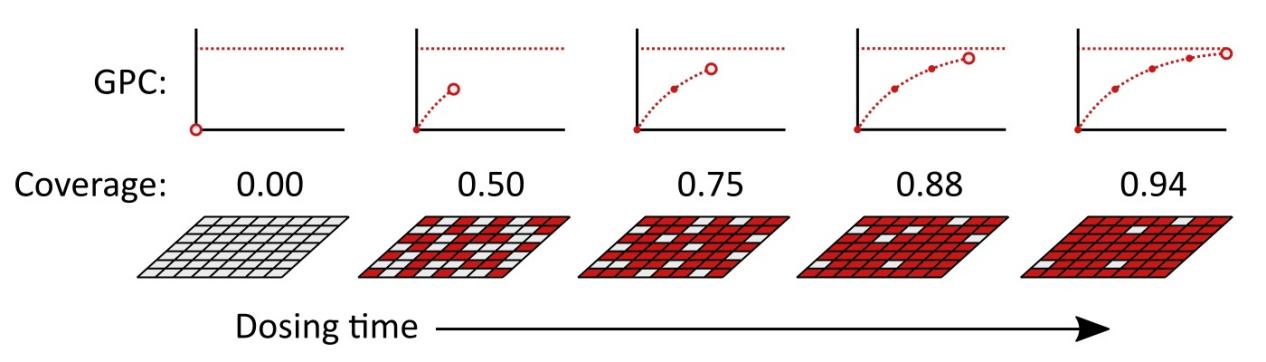
圖1:表面覆蓋率θ:在一個 ALD 半周期內,表面覆蓋率和 GPC 與給藥時間的關系。
在本篇文章中,我們將重點介紹使用 Arts, K 在研究中使用的模型所獲得的結果,該連續模型由兩個耦合方程組成:(1) 描述不可逆吸附的著名朗繆爾方程;(2) 用于計算高 AR 結構內氣相反應物密度的一維擴散方程。
氣相反應物分子的不可逆吸附用粘附概率 S 來描述:反應物分子在碰撞時不可逆吸附或“粘附"到表面的概率。注意,當表面覆蓋率 等于 1 時,這個概率在飽和狀態下應該為零。如果不是,生長將繼續,我們模擬的是化學氣相沉積 (CVD) ,而不是 ALD。
在采用的 Langmuir 模型中,使用 S=S0(1-θ) 來模擬 ALD 的自終止行為。這里,S0 是初始粘附概率:在模擬半周期的反應物之前對應起始表面的粘附概率。根據 ALD 工藝的不同,初始粘附概率通常在 10-5 到 10-1 范圍內。這意味著在發生不可逆吸附之前,反應物分子可以與表面碰撞約 10 到 100,000 次。
除了吸附,氣相反應物物種也可以通過復合從表面脫附,如通過等離子體 ALD ,反應性自由基可以復合形成穩定的分子,但這些分子不會作用于薄膜生長。例如,原子氧(O)可以復合形成穩定的分子 O2。同樣,在基于臭氧的 ALD 過程中,反應性臭氧也可以通過表面反應形成分子 O2 而丟失。在這兩種情況下,這種損失通道是使用表面復合概率r來模擬的:反應物分子(或原子)在與表面碰撞時復合的概率。與前驅體或共反應物的初始粘附概率類似,等離子體自由基的表面復合概率通常在10-5到10-1的范圍內。
“吸附損失"和“復合損失"之間有兩個主要區別,如圖 2(IIa和 IIb)所示。首先,吸附反應會導致薄膜生長,從而增加表面覆蓋率,而復合反應則不會。其次,當接近飽和時,吸附損失會停止,這樣反應物分子就可以擴散到高縱橫比更深的地方,直到找到可用的未反應吸附位點。相比之下,復合損失在結構中的任何地方都會繼續發生,因此往往占主導地位。
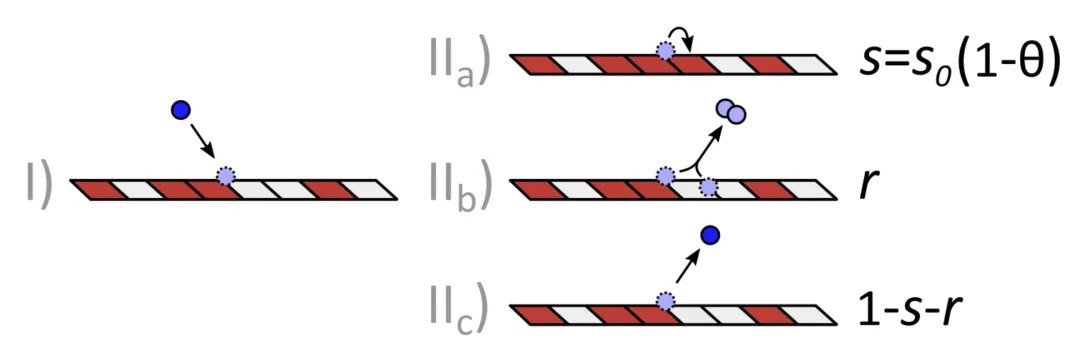
圖 2:(等離子) ALD 過程中氣相反應物(藍色圓圈)與表面之間的模擬相互作用圖,其中方塊代表空的(白色)和已占用的(紅色)吸附位點。當反應物分子或原子撞擊表面 (I) 時,它可以吸附在空的吸附位點 (IIa ),與表面上的另一個原子重新結合 (IIb ) 或反射 (IIc )。只有吸附 (IIa ) 才能增加表面覆蓋率。
初始粘附概率 S0 和復合概率r是決定生長機制和最終薄膜保形性的重要參數。下面將討論這些不同的生長機制,其中模擬結果假設為“單粒子",自由分子在狹窄的溝槽中擴散(即間隙高度h≤溝槽寬度,見圖3)。雖然實際情況通常更為復雜,考慮到氣相碰撞、復雜的 3D 幾何形狀等,但總體行為本質上是通用的,通常在低壓力下(例如,對于微米級孔或溝槽的壓力<1托)是現實的。
02.熱ALD:反應限制生長與擴散限制生長
對于熱驅動 ALD 而言,復合通常不起作用 ( r=0),我們可以區分兩種不同的生長機制:反應限制生長和擴散限制生長。圖3說明了反應限制生長和擴散限制生長之間的差異。在反應限制生長(左)中,氣相反應分子的吸附所需的時間比這些分子擴散到高 AR 結構中所需的時間更長。在擴散限制生長(右)中,反應物分子在它們擴散到結構末端之前就已經吸附了。根據此描述您可能會猜到,擴散時間 tdiff 與吸附時間 tads之間的比率決定了薄膜生長是反應限制的( tdiff/tad≤1) 還是擴散限制的 (tdiff/tads≥1)。

圖 3:反應限制生長(左)和擴散限制生長(右)的圖示
這里,我們使用擴散時間作為反應物分子擴散到高 AR 結構末端所需的時間。對于時間t內的“隨機游走"擴散,反應物分子的平均穿透深度隨著 √t而增加。相應地,到達結構末端所需的時間隨著縱橫比的平方而增加,所以tdiff ∝ AR2,其中AR = L/h。
吸附時間是指“填滿"一定比例的吸附位點所需的時間。無論這個比例是多少(1/e、0.5、0.9999……),吸附時間都與發生吸附反應所需的平均碰撞次數成正比。在最初的空表面上,這個碰撞次數等于 1/S0,因此,它成立 tads ∝ 1/S0。
對于溝槽中的分子擴散,擴散時間與吸附時間之比可以通過 tdiff/tads =3/4 S0(L/h)2 或更粗略地計算為 tdiff/tads≈S0AR2。雖然正式推導并不那么簡單,但可以使用比例 tads ∝ AR2 和 tads ∝ 1/S0 上述解釋來理解這個表達式。對于 S0AR2的低值,大致當S0AR2 < 1時,擴散比吸附快得多,并且我們有反應限制的增長。另一方面,當S0AR2 > 100 時,薄膜生長受到擴散限制。
我們現在將使用下面的動畫來討論這兩種情況,動畫展示了溝槽中 ALD 的橫截面側視圖。這里,為了清晰起見,并為了與我們實驗中使用的PillarHall™ 橫向高縱橫比溝槽結構(由 Puurunen 及其同事開發,由芬蘭 VTT 技術研究中心提供)進行比較,溝槽呈水平方向。圖 4 展示了這種 PillarHall™ 結構。在以下動畫中,藍線繪制了氣相反應物密度(從 0 到 1)。表面覆蓋率θ 最終決定了沉積膜的厚度,在溝槽表面上以紅色輪廓表示。

圖 4:在實驗中使用的由 VTT 提供的 PillarHall ™水平溝槽結構圖片(頂部),其中硅膜被移除,沉積的薄膜可見。結構的示意橫截面(中間)顯示了氣相反應物密度(藍線)和表面覆蓋率(紅色輪廓)。
第一個動畫,其中 S0AR2=0.01,對應于反應限制生長。為了完整地表示生長過程,此動畫分為“短時間尺度"部分和“長時間尺度"部分。在現實生活中,這些階段分別大約需要微秒和秒,具體取決于實驗條件。在短時間尺度部分,我們可以看到藍線移動到溝槽中,直到它在各處具有相同的值。這對應于氣相反應物分子擴散到溝槽中,直到它們均勻分布。在長時間尺度部分,我們可以看到這導致表面覆蓋率均勻增加,如紅色輪廓所示。
.gif)
動畫 1:模擬反應限制生長,其中 S0AR2 =0.01。在本博客文章的所有動畫中,紅色輪廓代表表面覆蓋率,藍線代表溝槽內的氣相反應物密度。此外,底部還包含一條小時間線,以指示動畫的進展。
由于反應限制生長過程中生長速率均勻,高 AR 結構中達到薄膜飽和所需的反應物劑量與平面基底相同。相應地,飽和劑量與成正比 1/S0A0,其中 A0 是每個吸附位點的平均有效面積。在圖 1 和 3 中,該面積A0對應于一個正方形的面積,代表一個吸附位點。
下一個動畫對應于擴散限制生長。在這里,S0AR2=1000 反應物分子在擴散到溝槽深處之前就已經吸附了。因此,薄膜在入口附近達到飽和,而溝槽內部深處的表面仍然是“空的"。隨后,在入口附近的飽和區域中,反應物分子不再通過吸附而損失,因此可以擴散到仍有空吸附位點的“吸附前沿"。因此,薄膜生長越來越深入溝槽。
(3).gif)
動畫 2:模擬擴散限制生長 S0AR2=1000。
請注意,沉積膜的穿透深度不是由反應物分子擴散的時間決定的,而是由供應到溝槽中的反應物分子的數量決定的。這是因為吸附位點必須“填滿"才能達到此深度,如圖 3(右)所示,為此也需要一定數量的反應物分子。因此,穿透深度與反應物劑量成比例,即反應物壓力乘以劑量時間。這不是線性關系,因為并非每個在溝槽內隨機擴散的分子都會到達吸附位點:它也可以移出溝槽。由于這種隨機游走擴散,沉積膜的穿透深度與 PD50% ∝ h(√A0Dose)成比例,其中PD50%是所謂的半厚度穿透深度。請注意,當 A0 較大時,表面上需要填充的吸附位點較少,沉積膜的穿透深度也更深。
擴散限制生長期間沉積薄膜穿透深度的表達式也可用于預測飽和劑量Dosesat,因為當穿透深度PD50%與溝槽的總長度L相同時,大約達到飽和狀態。因此,h√(A0Dosesat) ∝ L,利用縱橫比 AR=L/h,可以得出Dosesat∝(1/A0)AR2。請注意,這里的飽和劑量不受反應物反應性的影響,而僅受縱橫比和吸附位點數量的影響。這解釋了 Gordon 模型在假設粘附概率為 1 的情況下成功預測擴散限制生長的飽和劑量的原因。
雖然初始粘附概率的值不會影響擴散限制生長過程中的穿透深度,但它會影響覆蓋輪廓的形狀,下面給出的動畫說明了這一點。其中表面覆蓋率作為縮放距離Z/L進入溝槽的函數繪制。如果氣相反應物分子非常“粘",它們最有可能直接吸附在吸附前沿,在那里它們首先遇到空吸附位點。相反,如果值 S0 較低,反應物分子在吸附之前可以更頻繁地四處散射,從而使吸附前沿更加分散。請注意,這種前沿的“銳度"與反應物劑量保持不變,并且在第一次近似中僅由 S0決定。因此,可以使用該關系通過實驗確定與穿透深度的半周期相對應的值,如 Arts, K 的論文“從它們對薄膜保形性的影響中提取 Al2O3 原子層沉積過程中 H2O 和 Al(CH3)3 的粘附概率"中所述。
(4).gif)
動畫 3:在擴散限制生長過程中,對于不同的初始粘附概率值,表面覆蓋率與進入溝槽的距離的關系。
03.等離子體 ALD:復合限制生長
對于等離子 ALD,保形性問題變得更加困難。如“模擬 ALD 保形性"部分所述,擴散到溝槽中的等離子自由基也可能通過復合而損失,如表面復合概率所示r,而不僅僅是通過吸附。復合損失的存在通常會導致復合限制生長,其中反應物(此處為等離子自由基)進入高 AR 結構的滲透深度受到復合的限制。
為了確定薄膜生長是否是復合限制的,可以使用 rAR2的值。類似于前面部分討論的參數S0AR2,rAR2的值代表擴散時間和復合時間之間的比率。當 rAR2 ≥1 時,等離子體自由基在它們能夠擴散到溝槽末端之前就復合了,使得薄膜生長受到復合限制。當 rAR2 ≤ 1時,等離子體自由基可以到達溝槽的末端,并根據 S0AR2 的值提供反應限制或擴散限制生長。請注意,在這種情況下,沉積薄膜的穿透深度可能受到前體半周期的限制,而不是等離子體半周期。
在以下動畫中,我們可以看 rAR2 的值如何影響薄膜生長。這里,S0AR2 保持在 1000 恒定,rAR2 從100變化到1000和10000,使得在所有三種情況下薄膜生長都受到復合限制。最引人注目的是,可以看到等離子體自由基的穿透深度,因此沉積薄膜的穿透深度對于較低的復合概率值更高。對于 rAR2 = 100,薄膜生長最終達到溝槽的大約一半,而對于 rAR2 = 10000,只有結構的前 5%被涂層包覆。作為一個經驗法則,當 rAR2 ≈ 1 時,仍然可以相對容易地涂層高 AR 結構。或者換句話說,可以在等離子體 ALD 過程中輕易達到的縱橫比可以通過 AReasy ≈ 1/√r估計。在我們的工作中,我們確定 ?? ≈ 6 × 10-5用于等離子體 ALD 的 SiO2 和 TiO2,因此使用擴展的等離子體步驟實現了高達 AR ≈ 900 的薄膜生長。這表明等離子體 ALD 也可以產生非常共形的薄膜。
(1).gif)
動畫 4:不同值和固定值的復合限制生長模擬 S0AR2
讓我們更仔細地看看復合限制生長期間的總體生長行為。再次,上面顯示的動畫被分成兩部分。在“短時間尺度"部分,自由基擴散進入溝槽,并通過吸附反應和復合反應同時丟失到側壁。在“長時間尺度"部分,我們可以觀察到復合損失如何影響薄膜生長。首先,在溝槽入口附近的區域達到了表面覆蓋率的飽和。由于在該飽和區域不再發生吸附損失,自由基可以更深入地進入溝槽。盡管如此,復合損失繼續進行,也在飽和表面上,因此最終限制了自由基可以擴散的深度。在這一點上,形成了進入溝槽的自由基通量和通過表面復合持續丟失自由基之間的平衡。這種平衡導致自由基密度的穩態指數衰減,如藍線所示。
請注意,當S0AR2 ≤ rAR2 時,復合損失立即占主導地位,所以也在溝槽開始處表面覆蓋率達到飽和之前。盡管如此,遲早也會得到同樣的自由基密度指數衰減,當 S0AR2 > rAR2時,正如下面所示的動畫所示。因此,S0AR2 的值影響覆蓋率輪廓的形狀,但在復合限制生長期間對沉積薄膜的穿透深度影響相對有限。
(1).gif)
動畫 5:模擬固定值 rAR2 和非常不同的值的復合限制生長 S0AR2
自由基密度的指數衰減有幾個實際后果。正如已經提到的,它限制了可以相對容易涂層的縱橫比(AReasy≈ 1/√r)。也可以達到更高的縱橫比,但需要成指數級的時間來實現高AR結構內部更深的薄膜飽和。因此,達到整個結構飽和所需的劑量時間隨著縱橫比的增加而指數增加。此外,沉積薄膜的穿透深度與自由基劑量對數增加。這種關系可以用來實驗確定 的值,如我們的論文“等離子體輔助原子層沉積 SiO2、TiO2、Al2O3 和 HfO2 期間薄膜共形性和提取的 O 原子復合概率"中解釋的。
總結
我們希望這篇博文有助于解釋和理解(等離子) ALD 過程中保形薄膜的生長,同時,也向大家分享以下幾條經驗:
1粘附概率和表面復合概率是決定(等離子)ALD 過程中薄膜保形性的重要參數。
2與吸附相反,表面復合是持續存在的,因此往往成為等離子體 ALD 過程中活性物質的主要損失通道。
3對于表面復合概率較低的工藝,等離子 ALD 也可以提供出色的薄膜保形性。
參考文獻
【1】K. Arts, W.M.M. Kessels and H.C.M Knoops. Basic insights into ALD conformality – A closer look at ALD and thin film conformality. 2020, 1. AtomicLimits.
【2】Arts, K.; Vandalon, V.; Puurunen, R. L.; Utriainen, M.; Gao, F.; Kessels, W. M. M. (Erwin); Knoops, H. C. M. Sticking Probabilities of H2O and Al(CH3)3 during Atomic Layer Deposition of Al2O3 Extracted from Their Impact on Film Conformality. J. Vac. Sci. Technol. A 2019, 37 (3), 030908.
【3】Arts, K.; Utriainen, M.; Puurunen, R. L.; Kessels, W. M. M.; Knoops, H. C. M. Film Conformality and Extracted Recombination Probabilities of O Atoms during Plasma-Assisted Atomic Layer Deposition of SiO2, TiO2, Al2O3, and HfO2. J. Phys. Chem. C 2019, 123 (44), 27030–27035.
【4】 Knoops, H. C. M.; Langereis, E.; van de Sanden, M. C. M.; Kessels, W. M. M. Conformality of Plasma-Assisted ALD: Physical Processes and Modeling. J. Electrochem. Soc. 2010, 157 (12), G241–G249.
【5】Cremers, V.; Puurunen, R. L.; Dendooven, J. Conformality in Atomic Layer Deposition: Current Status Overview of Analysis and Modelling. Appl. Phys. Rev. 2019, 6, 021302.